Gebraucht ESEC 3088iP #9091720 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom
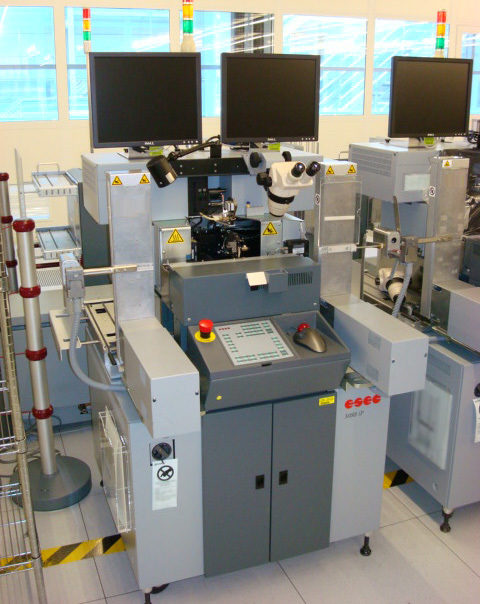

ID: 9091720
Weinlese: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP ist eine industrielle Halbleiterverpackungsmaschine zur Herstellung dichter elektrischer Verbindungen zwischen den einzelnen Stiften eines Halbleiterchips und seinen Anschlüssen. Die Maschine verwendet eine fortschrittliche Keil- und Bar-Bonder-Technik, um die Herstellung von Präzisions-Halbleiterpaketen mit hohem Durchsatz zu ermöglichen. Das ESEC 3088I P-Paket besteht aus mehreren Hauptkomponenten, darunter einer digitalen Touchscreen-Schnittstelle, einem Ultraschall-Bonderkopf, einem Ausrichtsystem, einer Parametersteuereinheit und einer Bonddatensteuereinheit. Die digitale Schnittstelle ermöglicht eine einfache und intuitive Maschinensteuerung sowie die Auswahl und Anzeige von Prozessparametern. Der Ultraschall-Bonderkopf besteht aus einem zweiachsigen System, das in der Lage ist, eine breite Palette von Packungsgrößen und Zuleitungslängen zu handhaben. Das Ausrichtsystem besteht aus einem Mikroskop, einer CCD-Zeilenkamera und einem Translation-Mikrometer-Kopf. Diese Kombination von Bauelementen ist in der Lage, die Ausrichtung zwischen der Leiterplatte und den Chipführungen zu messen, um eine genaue Verklebung zu gewährleisten. Die Parametersteuereinheit dient zur Steuerung der verschiedenen Eigenschaften des Verbindungsprozesses wie Frequenz, Leistung, Fluß, Keilkraft, Elektrodenschaufeldruck und Verbindungskraft. Die Bonddatensteuerung dient zur Speicherung und Überwachung der Bonddaten zur Qualitätssicherung und Rückverfolgbarkeit. 3088 IP-Einheit bietet eine schnelle und bequeme Bondlösung für automatisierte Fertigungsprozesse. Die Maschine hat einen hohen Durchsatz und kann eine Vielzahl verschiedener Halbleiterpakete verarbeiten, darunter Multi-Chip-Module (MCM), Quad-Flat-No-Lead-Pakete (QFN), kleine integrierte Schaltungen (SOIC) und Chip-Scale-Pakete (CSP). Es enthält auch erweiterte Funktionen wie automatisches Strom- und Temperaturmanagement, erweiterte Flusssteuerung, Pulsoszillation und Mehrpunktkraftsteuerung. Das Gesamtdesign der Maschine reduziert das Risiko der Beschädigung der Verpackung oder der Leitungen während des Verbindungsprozesses erheblich. Darüber hinaus ermöglichen die hochwertigen Ergebnisse, die die Maschine erzeugt, einen fehlerfreien Betrieb und schaffen ein Maß an Sicherheit mit dem Benutzer, dass die Bondoperationen mit höchster Genauigkeit und Zuverlässigkeit durchgeführt werden.
Es liegen noch keine Bewertungen vor