Gebraucht EATON NOVA / AXCELIS GSD 200E2 #9021872 zu verkaufen
Es sieht so aus, als ob dieser Artikel bereits verkauft wurde. Überprüfen Sie ähnliche Produkte unten oder kontaktieren Sie uns und unser erfahrenes Team wird es für Sie finden.
Tippen Sie auf Zoom
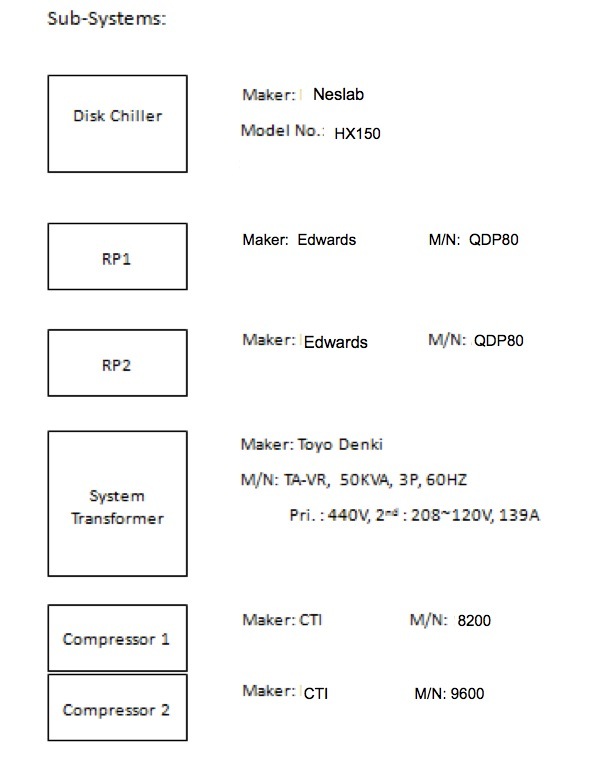

Verkauft
ID: 9021872
Wafergröße: 6"-8"
HC implanter, 6"-8"
180 KeV
Line power:
Input power: 208 V, 3 phase, 60 Hz, 92 A, 33 kVA, I/P breaker: 125 A
Output power: 180 KeV, 20 mA
Endstation module:
Mini-environment: Synetics
ATM robot: SEN
Notch / flat finder: flat
Dummy cassette: 2 in 1
Load buffer: 1
Vacuum cassette: domed pin
Cassette table: 4
Load port interface: manual
Beam profile oscilloscope: Tektronix TDS210
Cell controller / version: MVME 177-03
Load lock type: GSD 100/200, HE
Main SUN computer: Sparc Station 5
Second SUN computer: Spare 5
Second SUN monitor: Sun
Tape reader: n/a
Printer: HP
Process module:
Disk: none
Faraday flag: Y (no burn-through sensor)
Electron / plasma shower: secondary electron
Plasma shower PS: EMI EMS series
Bias aperture: Y
Shower gas panel: Y (Ar)
Ar / Xe bleed MFC: Unit 5 SCCM
In-vac arm: Y
Wafer holder: Y
Pedestal: Y
Gyro / angle: NF-GSD 100, Quad ± 11 deg
Linear drive: Y
Rotary drive: direct drive
HYT: no
Beamline module:
HV power supply: Advance HV
HV stack: OL8000/104/05, 100 kV
Prost accel. volt: OL800/104/05, 100 kV
Extraction suppression PS: Glassman, m/n: PS/NV-15NN33
AMU: BSL
AMU PS: EMI EMS 40-150
Hall probe: AMU
Max extraction voltage: 90 KeV, max acc. voltage: 90 KeV
Beam profiler hole: extended Y-scan
Decel. funcion: n/a
Beamline purge kit: Y
Beamline turbo: Y
Source module:
Source head: ELS without vaporizer
Filament PS: EMS 10-60
Arc PS: EMS 150-7
Cathode PS: Y
Vaporizer PS: present
Source magnet: std
Source magnet PS: EMS 25-25
Source bushing: std (orange)
Extraction assembly: LE-VAE, 33 type
Selectable resolving aperture: Y
Source ISO transformer: dry
Source injection kit: MKS 1150 vapor source MFC
Source housing exhaust valve: Y
Gas box module:
Gas box type: modular
Gas loop #1: Ar, HP (external supply)
Gas loop #2: BF3, SDS (fitting: 1/4" VCR)
Gas loop #3: AsH3, SDS (fitting: 1/2" VCR)
Gas loop #4: PH3, SDS (fitting: 1/2" VCR)
Loop #1 MFC: MKS, m/n 1179A-14493, 10 sccm, N2, gold finger conn.
Loop #2 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #3 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #4 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Vacuum system:
P1 / source turbo: Seiko Seiki, STP-A2203C
P8 turbo: Leybold 1000C
P3 / V3 cryo pump: CTI-10
P9 / disk cryo pump: n/a (flange ready)
RP2: Ebara A70W, 200-220 V, 3 phase, 50/60 Hz, 29.5 A
IG1: glass, G-75
PIG1: n/a
IG2: glass, G-75
IG3: glass, G-75
IG4: n/a
IG controller: GP-307
Safety options:
VESDA: n/a
Smoke detector: Y
CES options: n/a
Others:
Enclosures: OK
Ground bars: 5
SECS / GEM function: GEM
SPC function: yes
Dose controller PComp. algorithm type: standard PComp.
Crated
1998 vintage.
EATON NOVA/AXCELIS GSD 200E2 ist ein Ionenimplantator und -monitor. Es ist für den Einsatz in Halbleiterherstellungsanlagen für den Prozess der Ionenimplantation konzipiert. Dieses Verfahren wird verwendet, um verschiedene Materialien mit verschiedenen Ionen zu modifizieren, um verschiedene Eigenschaften oder Merkmale im Material zu erzeugen, wie das Hinzufügen von Dotierstoffatomen zu Siliziummaterial für spezialisierte elektronische Eigenschaften. AXCELIS GSD 200E-2 verwendet proprietäre Komponenten wie die OptiCap Hybrid Beam Shaping Technologie und IonControl SmartScan Ionenstrahlliefergeräte, um höchste Präzision und Genauigkeit im Implantierungsprozess zu gewährleisten. Dies ist wesentlich, damit das erhaltene Material die gewünschten Eigenschaften und Merkmale aufweist. EATON NOVA GSD 200 E2 verwendet auch eine Reihe von Sensoren zur Überwachung partikulärer Verunreinigungen in der Implantationskammer sowie zur Verfolgung der Systemleistung und -diagnostik. Dies ist wichtig, um sicherzustellen, dass der Implantationsprozess für höchste Qualität im resultierenden Material optimiert wird. EATON NOVA GSD 200E2 Einheit besteht aus mehreren Komponenten, darunter eine Ionenquelle, Implantatkammer, Vakuumpumpmaschine, HF-Beschleunigung, Hochspannungs-Tool, Ion Control Console, und ein High Paramerter Control Asset. Die Ionenquelle ist für die Erzeugung der Ionen für den Implantationsprozess verantwortlich, während die Implantatkammer diese Ionen beherbergt und hilft, sie auf das entsprechende Energieniveau zu beschleunigen. Das Vakuumpumpenmodell ist dafür verantwortlich, die geeignete Vakuumumgebung für die fortgesetzte Implantation zu schaffen. Die RF-Beschleunigungsausrüstung steigert die Ionen auf ihre benötigten Energiezustände für die Implantation. Das Hochspannungssystem liefert die für diese Prozesse notwendige elektrische Leistung. Die Ion Control Console ermöglicht es dem Bediener, den Implantationsprozess zu steuern und die High Parameter Control Unit ermöglicht die Überwachung des Implantationsprozesses und der zusätzlichen Sensoren. Darüber hinaus verfügt EATON NOVA GSD 200E-2 über eine integrierte Passive Plasma-Neutralisationskammer, die eine separate Vorrichtung zur Neutralisierung der Implantationskammer überflüssig macht. Dieses Merkmal trägt dazu bei, dass eine höhere Kammerstabilität erreicht wird und weniger Verunreinigungen durch den Prozess entstehen. EATON NOVA/AXCELIS GSD 200E-2 ist ein fortgeschrittener Ionen-Implantierer und Monitor, und es ist wichtig, um sicherzustellen, dass die höchsten Maße an Präzision und Genauigkeit im Implantationsprozess erreicht werden, und dass das resultierende Material die gewünschten Eigenschaften hat. Aus diesem Grund wird es in vielen Halbleiterherstellungsanlagen auf der ganzen Welt eingesetzt.
Es liegen noch keine Bewertungen vor