Gebraucht KLA / TENCOR SP1-DLS #9049192 zu verkaufen
Es sieht so aus, als ob dieser Artikel bereits verkauft wurde. Überprüfen Sie ähnliche Produkte unten oder kontaktieren Sie uns und unser erfahrenes Team wird es für Sie finden.
Tippen Sie auf Zoom
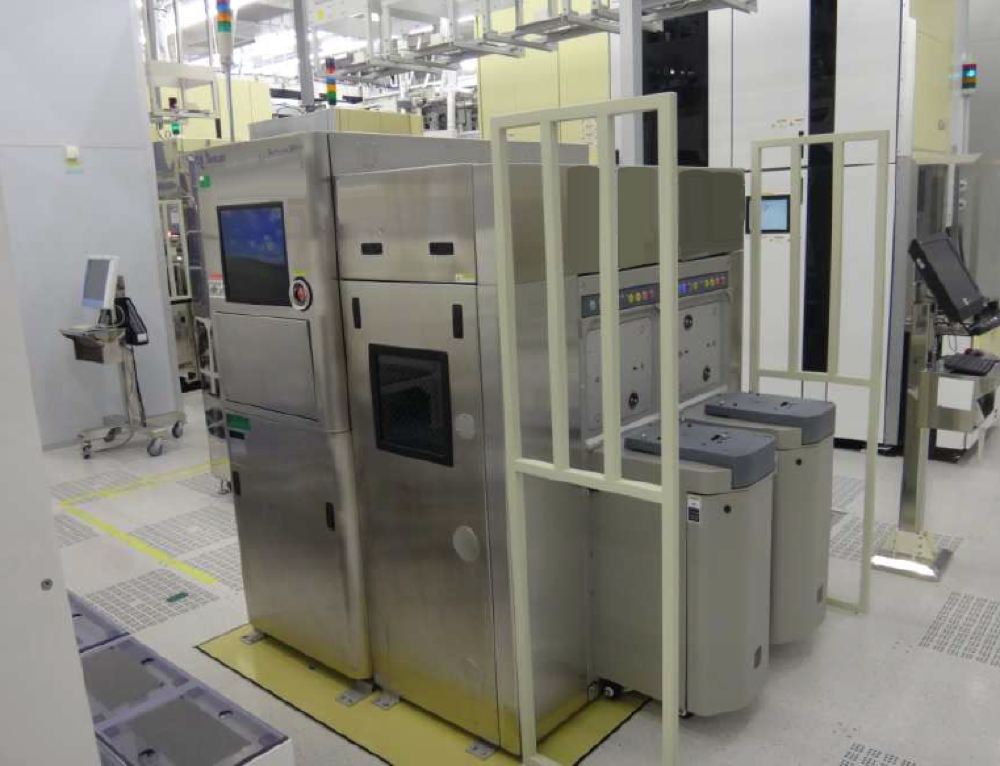

Verkauft
ID: 9049192
Wafer Surface Analysis System
Normal Illumination - 0.079Âum
Defect Sensitivity.0.005-ppm
Haze Sensitivity
Argon Ion Laser (488-nm)
RTDC (Real Time Defect Classification)
Measurement Chamber with ULPA Filter and Blower Unit
Operator Interface (integrated in Measurement Module)
Microsoft Windows XP 5.1 Operating System
Security, Logging & native Networking as provided by Windows XP
Interactive Pointing Device
Keypad Controls
TFT Flat Panel Display
Parallel Printer Port
Defect Map and Histogram with Zoom
MicroView Measurement Capability
Iomega 2GB Removable Jaz Drive
Operations Manual, Clean Room Book On Board, softcopy of SP1 Operations Manual
Software version 4.200
Hardware configuration:
Microsoft WinXP5.1
E40/E87/E90/E94
E84 enabled for OHT & AGV/RGV
GEM/SECS (Comm Port)
GEM/SECS (HSMS)
ASYST AXYS-21 Robot
300mm Dual FIMS Bulkhead Asyst
Two AdvanTag SingleWire CID
4 Color Light Tower
Brightfield.
KLA/TENCOR SP1-DLS (Scanning Probe 1- Defect Localization Equipment) ist ein fortschrittliches Masken- und Wafer-Inspektionssystem zur umfassenden Überprüfung von Produktions- und Entwicklungswafern für die Halbleiterherstellung. Es kombiniert vier verschiedene Technologiesäulen - optische, elektrische, Rastersondenmikroskopie (SPM) und Fehlerlokalisierung - zur Inspektion, Diagnose und Lokalisierung von Defekten auf Wafern und Masken. Das Gerät integriert hochauflösende Bildgebung von Waferoberflächen mit herkömmlicher Wafer-Messtechnik und Fehlerüberprüfung. Es ermöglicht eine gerichtete Fehlerüberprüfung mit Sub-Mikrometer-Auflösung - mithilfe von Sub Resolution Assist Features (SRAF) zur Identifizierung und Lokalisierung von Clustern. Eine Kombination aus automatisierter Prozesssteuerung zur Sicherstellung einer Qualitäts- und Tiefenanalyse für die Fehlerdiagnose ermöglicht eine zuverlässige, performante Waferinspektion. KLA SP1 DLS ist mit einer AWA-Maschine (Automated Wafer Alignment) für einfachen und konsistenten Waferaustausch ausgestattet. Sein SPM Alignment Tool (SAT) minimiert die Auswirkung von Wafer-Fehlstellungen auf die Bildgebung. TENCOR SP 1-DLS verfügt über ein RAPIDTM Wafer Recognition Tool (WRS), das detaillierte Prozessinformationen für jeden gescannten Wafer abruft. Die von der WRS gesammelten Daten werden zur Generierung automatisierter, hochauflösender Wafer-Karten vom mittleren bis zum tiefen UV-Bereich verwendet. Die Wafer-Oberflächenbildgebung auf KLA/TENCOR SP1 DLS hat eine optische Auflösung von Submikron über das gesamte weite Feld und eine Overlay-Leistung von 1 nm mit einer Detektionsfähigkeit von 0,2 nm. Seine Single Shot 3D Fehlerüberprüfung bietet größere Erkennungsergebnisse in kürzerer Zeit, während die wahrscheinlichkeitsbasierte Fehlerüberprüfung eine genaue Fehlerlokalisierung im 3D-Raum ermöglicht. TENCOR SP 1 DLS arbeitet mit einer breiten Palette von Sondierungswerkzeugen, einschließlich Rasterelektronenmikroskop (SEM), Röntgenstrahl und Elektronenstrahl (E-Strahl). Die SPM-Inspektion ermöglicht bis zu 10um Tiefenanalyse für flache Grabenisolierung (STI), chemisch-mechanische Planarisierung (CMP) und andere lokale planare Merkmale. Das Fehlerklassifizierungs-Tool ist auch für die Lokalisierung von Merkmalsfehlern verfügbar. Die Funktion Automated Defect Handoff (ADH) hilft dabei, KLA/TENCOR SP 1 DLS mit anderen bildgebenden Werkzeugen wie der Rastermikroskopie (SAM) und der Transmissionselektronenmikroskopie (TEM) zu verbinden. Dies ermöglicht eine umfassende Wafer-Inspektionslösung. Insgesamt ist SP1 DLS eine fortschrittliche Masken- und Wafer-Inspektion, die umfassende Fehlerüberprüfungs- und Diagnosefunktionen bietet. Die Kombination aus optischen, elektrischen, SPM- und Defekt-Lokalisierungstechnologien ermöglicht es Benutzern, Wafer mit Sub-Mikrometer-Auflösung zu inspizieren, Fehler im 3D-Raum zu erkennen und zu lokalisieren und auf Prozessinformationen für jeden gescannten Wafer zuzugreifen.
Es liegen noch keine Bewertungen vor