Gebraucht VON ARDENNE WM70H / C #9172921 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom




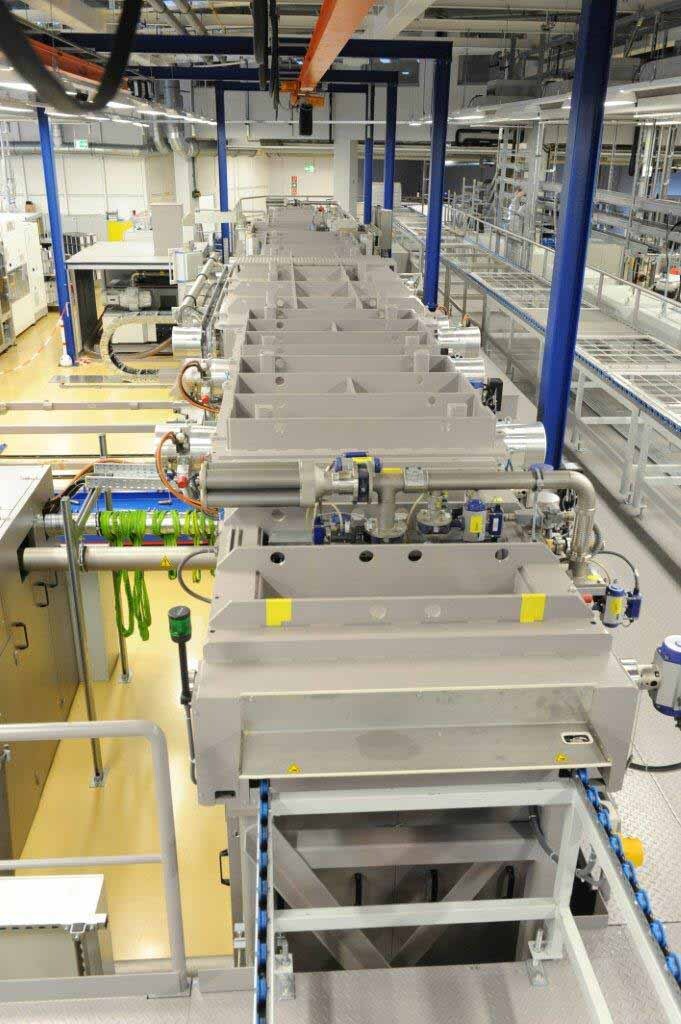



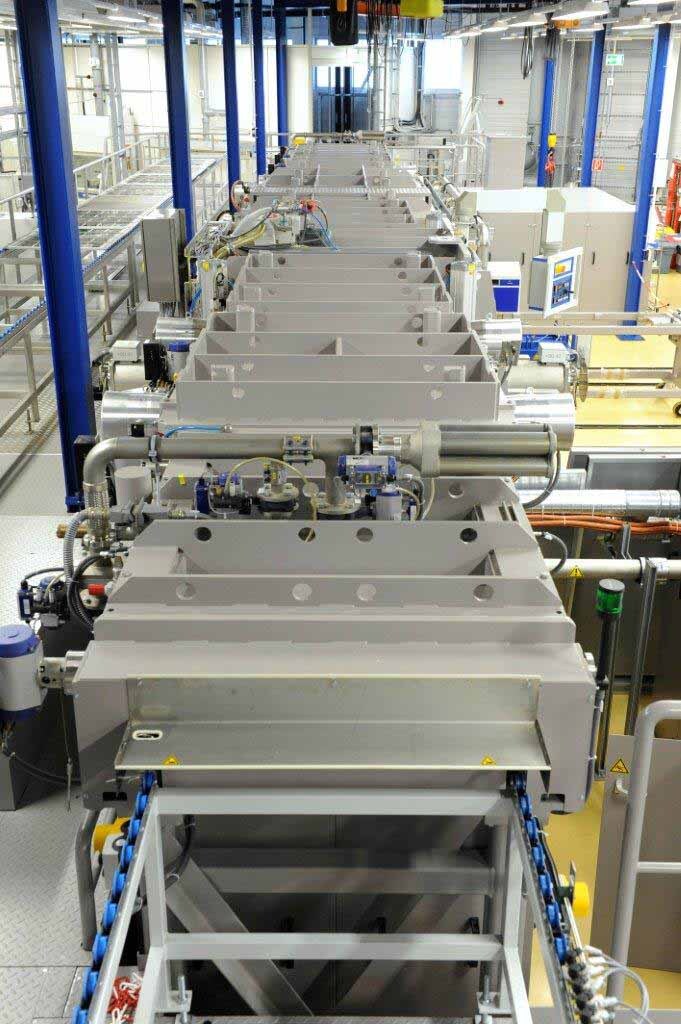



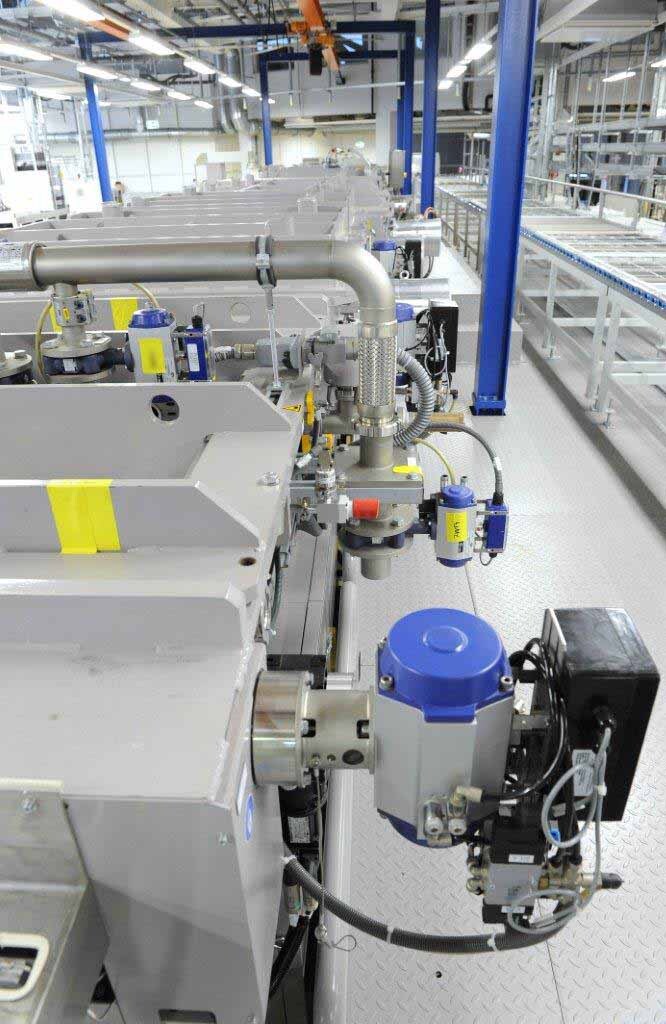

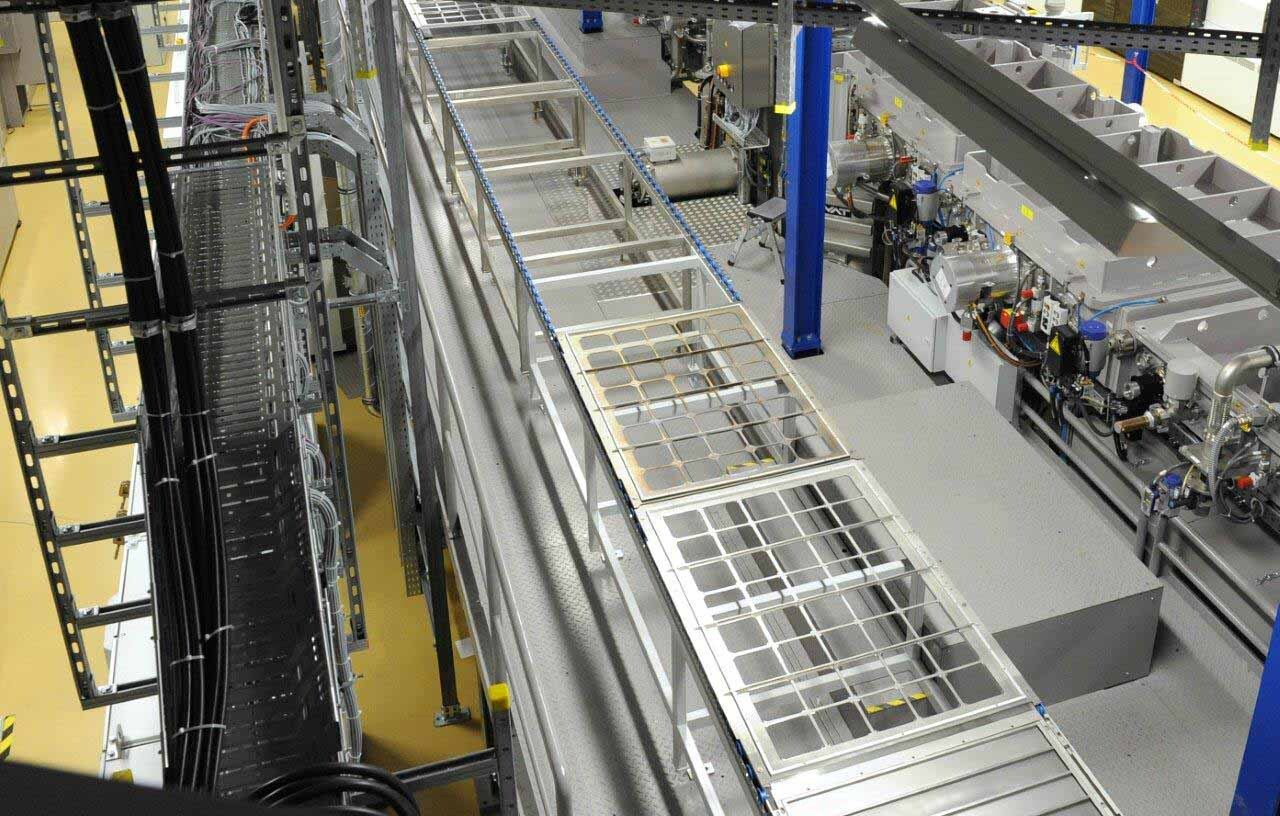



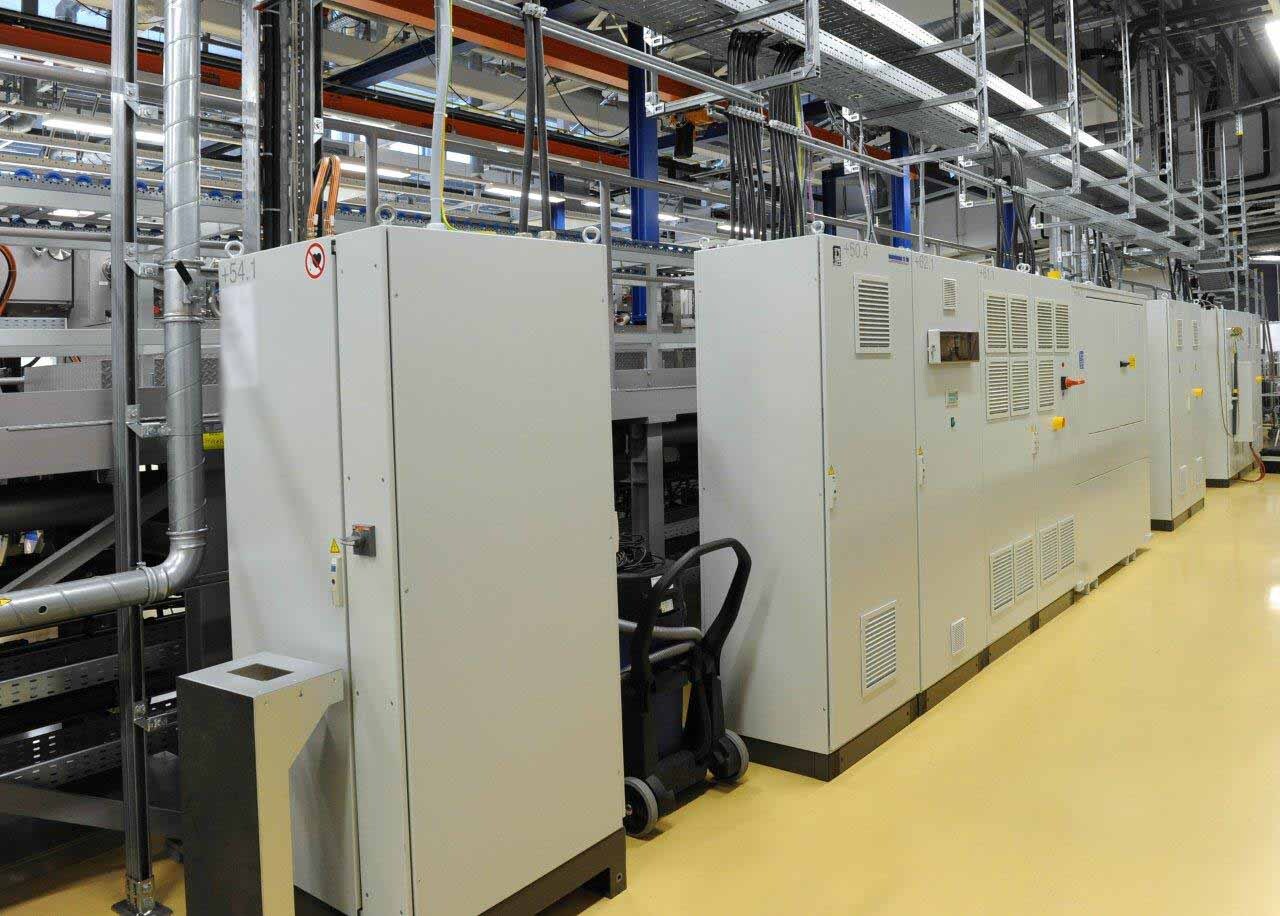







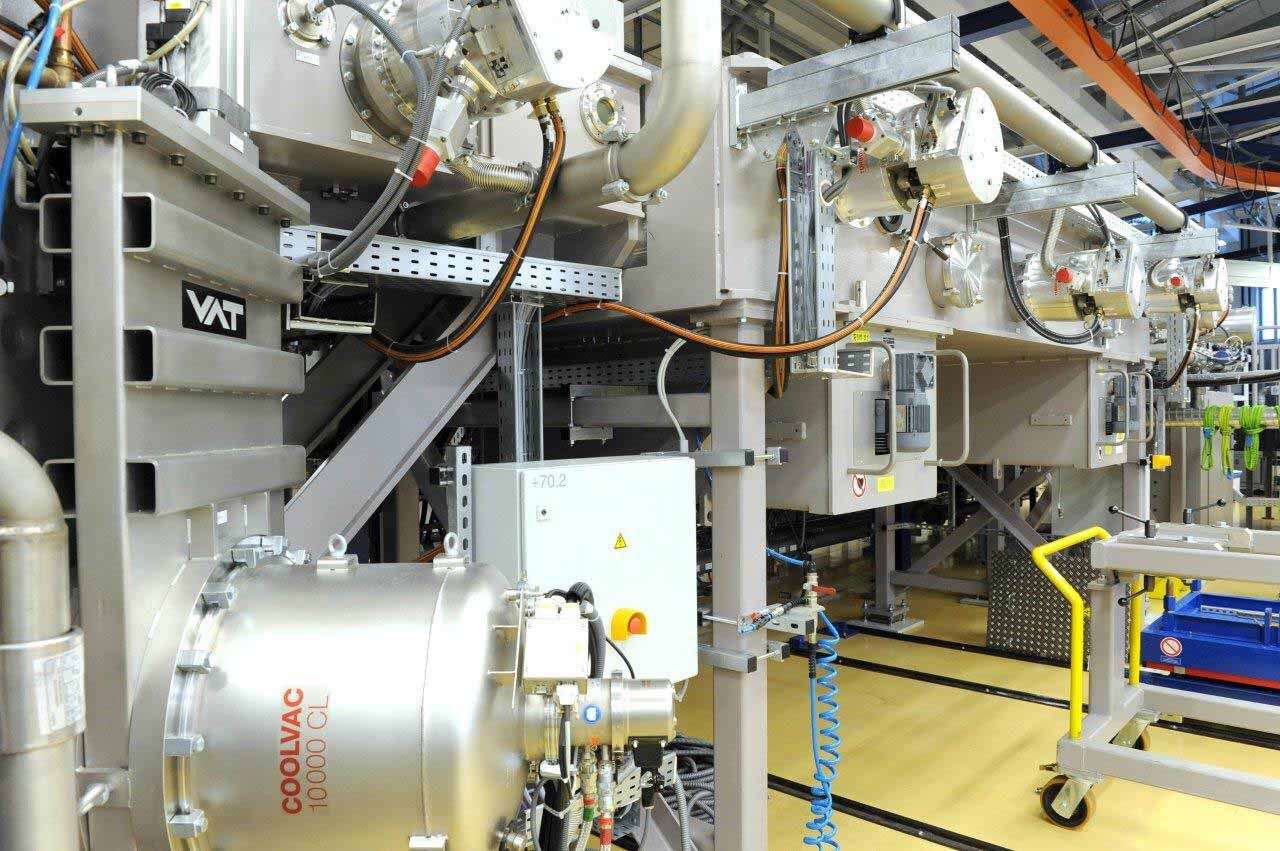





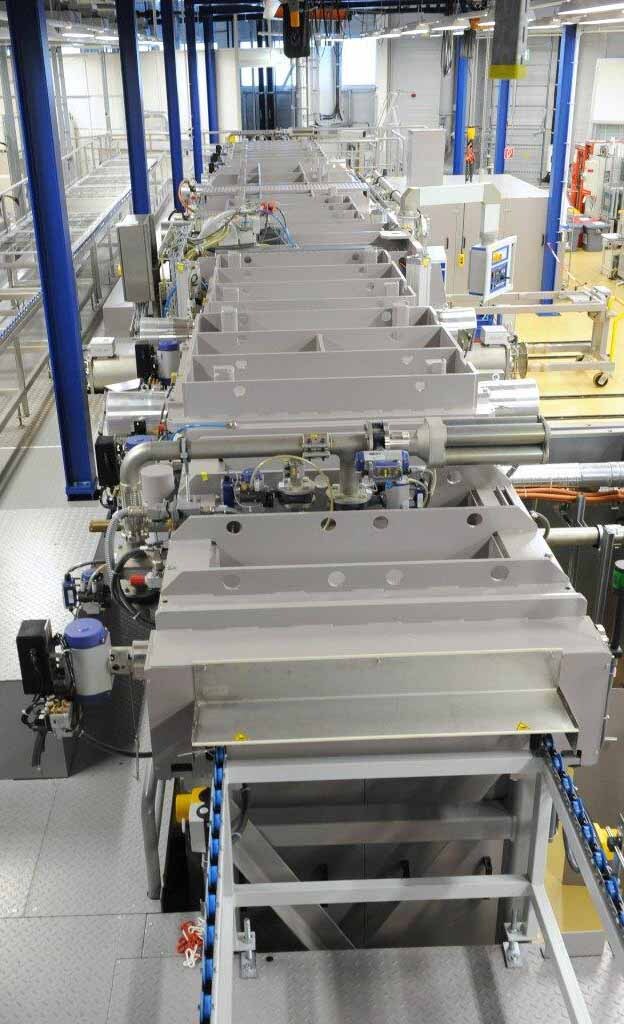













ID: 9172921
High end coating line
Wafer metallizer
In-line complete system for coating wafers
Back coating of silicon wafers with an aluminum layer
Coating of nickel, silver and aluminum by electron beam evaporation
(35) Cells can be coated per tray
Productivity:
4,000 Wafers (5") per hour
2,600 Wafers (6") per hour
Cycle time: 50s
Technical parameters:
System dimensions:
Length: 19 m
Area: 20 x 7 m
Height: ~3 m
Drive:
Carrier speed max: 5 m/min
Carrier speed during vapor deposition: 1.5 - 2.0 m/min
Substrate temperature:
Max. temperature: 300°C / 572°F
Carrier dimensions:
Length: ~1,450 mm
Width: 925 mm
(60) Wafers (5") per carrier
(40) Wafers (6") per carrier
Ambient conditions:
Ambient temperature:
+15 to 35 °C
+59 to 95 °F
Relative humidity at 30°C / 86°F: < 70 %
Dust: < 10 mg/m3
Sluice chambers C1 and C7
Buffer chambers C2 and C6
Transfer chamber C5
Process chamber C4:
EB Chamber C3 / C4.1 / C4.2
Sputter chambers
(5) Sections (C4.3 to C4.7)
Vacuum
Working pressure:
C2 - Buffer chamber 2 to 5 x 10-3 mbar
C4.1 - EB chamber 5 to 9 x 10-5 mbar
C4.2 - Intermediate chamber 2 to 5 x 10-4 mbar
C4.3 - Intermediate chamber 2 to 5 x 10-3 mbar
C4.4 - Sputter chamber 2 to 5 x 10-3 mbar
C4.5 - Pump chamber 2 to 5 x 10-3 mbar
C4.6 - Sputter chamber 2 to 5 x 10-3 mbar
C4.7 - Intermediate chamber 2 to 5 x 10-3 mbar
C5 - Transfer chamber 2 to 5 x 10-3 mbar
C6 - Buffer chamber 2 to 5 x 10-3 mbar
Leak rate: < 1 x 10-2 mbar l/s-1
Layer thickness / Properties:
AI with copper:
Thickness: 2 μm
Wafer thickness: > 200 μm
Temperature: 400°C / 752°F
Purity: 99.98%
AI with ceramic:
Thickness: 3 μm
Wafer thickness: 150 to 250 μm
Temperature: 300°C / 572°F
Purity: 99.5%
Ag: Thickness: < 300 nm
Sn: Thickness: < 300 nm
NiCr: Thickness: < 40 nm
Uniformity: ± 10%
Evaporation:
Production cycle: 120 h
Power of electron beam
Copper crucible: 100 to 200 kW
Ceramic crucible: 20 kW
Target material per cycle: 90 to 150 kg
Vapor utilization: 48 to 50 %
Target-substrate distance: 600 mm
Carrier frequency: 60s
Sputtering:
Target material: Ag
Target utilization: ~70%
Target life: 240 h
Cooling water:
Particle size: ~50 mg/l
pH Value: (8.0 to 9.0)
Electrical conductivity: (150 to 250) μS/cm
Acid capacity, Ks 4.3: (0.5 to 2.0) mmol/l
Filterable substances: < 50 mg/l
Chloride: < 10 mg/l
Sulfate: < 30 mg/l
Ammonium: < 0.5 mg/l
Nitrate: < 10 mg/l
Colony count (CFU): ~ 1,000 ml-1
TOC (total organic carbon): < 1.5 mg/l
Inlet temperature:
21 to 25°C
69.8 to 77°F
Differential pressure: 2 bar
Absolute pressure max: 8 bar
Water circuit 1 chambers:
Volume flow: TBD m3/h
Temperature: 25°C / 77°F
Required pressure: 6 - 8 bar
Cooling capacity: TBD kW
Electrical system:
3 Phases, 3 AC 480 V
Tolerance: -10/+6 %
Frequency: 59 to 61 Hz
Grounding resistance: <2 Ohm
Connected load max: 400 kVA
Function:
Wafers are coated on one side with (2) metal layers.
VON ARDENNE WM70H/C ist eine fortschrittliche Photoresist-Ausrüstung, die hochwertige Dünnfilmbilder und -muster herstellen kann. Das System wurde entwickelt, um Größen bis zu 70 nm in der Breite und 100 nm in der Höhe mit einer Genauigkeit von 2 nm zu schaffen. Die Einheit besteht aus mehreren Komponenten wie Photomasken, einer Lithographiemaschine, zahlreichen fluidischen Komponenten, einem Gasspender und einer Resistquelle. Die Photomasken, mit denen die Oberfläche des Wafers gemustert wird, werden zunächst in die Lithographiemaschine geladen. Dann geben die fluidischen Komponenten den Resist (ein chemisches Gemisch) schnell auf die Photomaske und den Wafer ab und helfen, ihn gleichmäßig zu verteilen. Der Resist wird dann einem Licht aus einer Flutquelle ausgesetzt, um ein Resistmuster zu erzeugen, das als Schablone fungiert, in die die Oberflächendetails gebildet werden. Ein Gasspender legt exakt einen Fluorkohlenstoffschutzfilm über die Resistoberfläche an, um den Gasstrom zu handhaben und die Emulsionskonsistenz zu versichern. Anschließend wird der Resist abgestreift, gespült und getrocknet, und der Wafer ist dann bereit, sich einem weiteren Ätzprozess zu unterziehen und den Resist abzuziehen. TheWM70H/C Maschine verfügt über die modernsten Komponenten auf dem Markt und bietet eine überlegene Bildplatzierung Genauigkeit, Präzisionsmusterdefinition und High-Fidelity-Film-Strukturierung für Halbleiter-Lithographie-Prozesse zwischen 70-100 nm. In Kombination mit einem harmonischen Nachätzwerkzeug bietet WM70H/C klare, detaillierte Merkmale mit einer Genauigkeit von 2 nm. Darüber hinaus garantieren das breite Parameterspektrum und der automatisierte Betrieb minimale Rüstzeiten, was zu signifikanten Produktivitätssteigerungen führt. Es ist ideal für Serienumgebungen mit fortschrittlichen Halbleiterprozessen.
Es liegen noch keine Bewertungen vor