Gebraucht JEOL JEM 2010F #293585832 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom
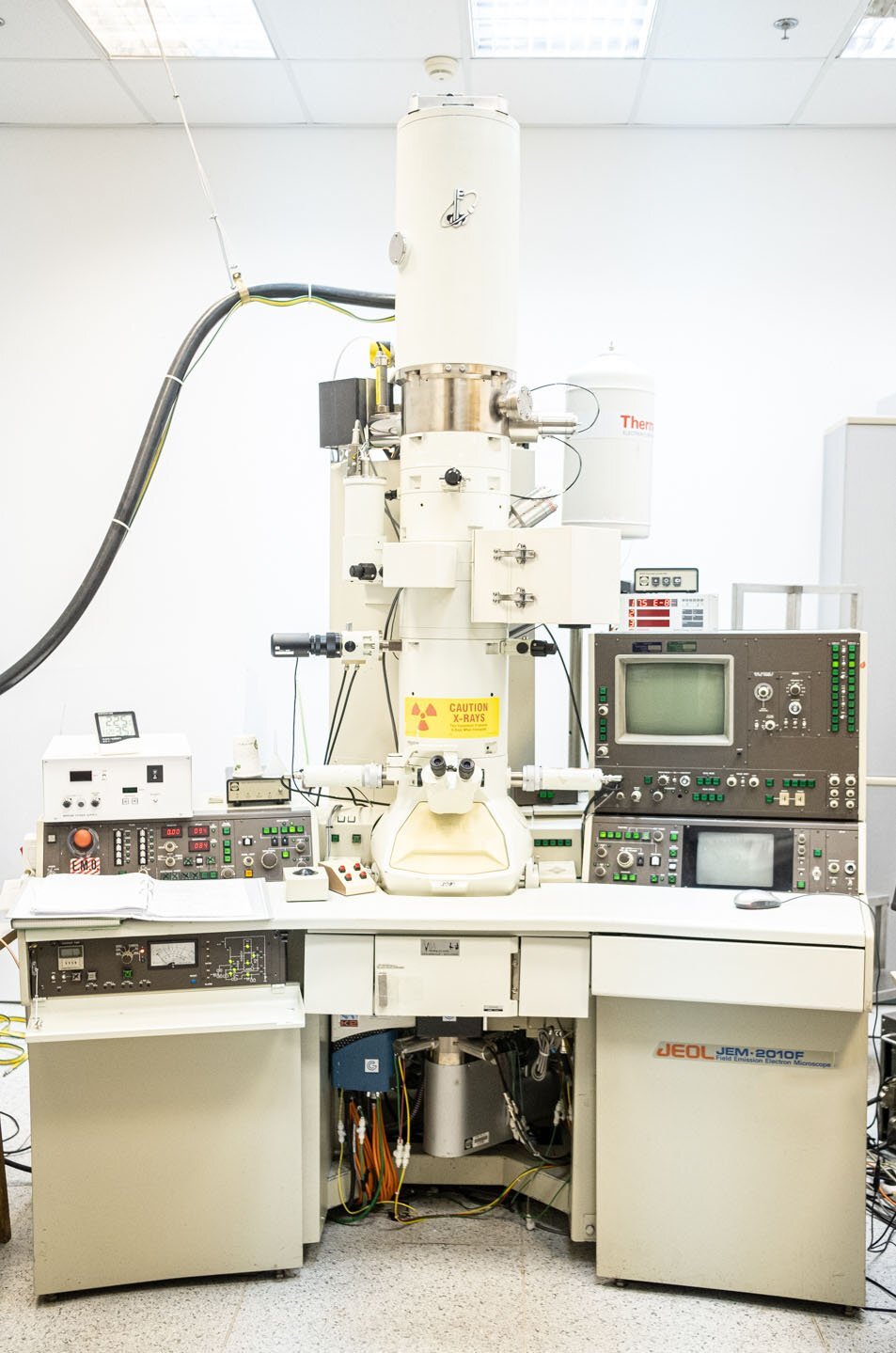





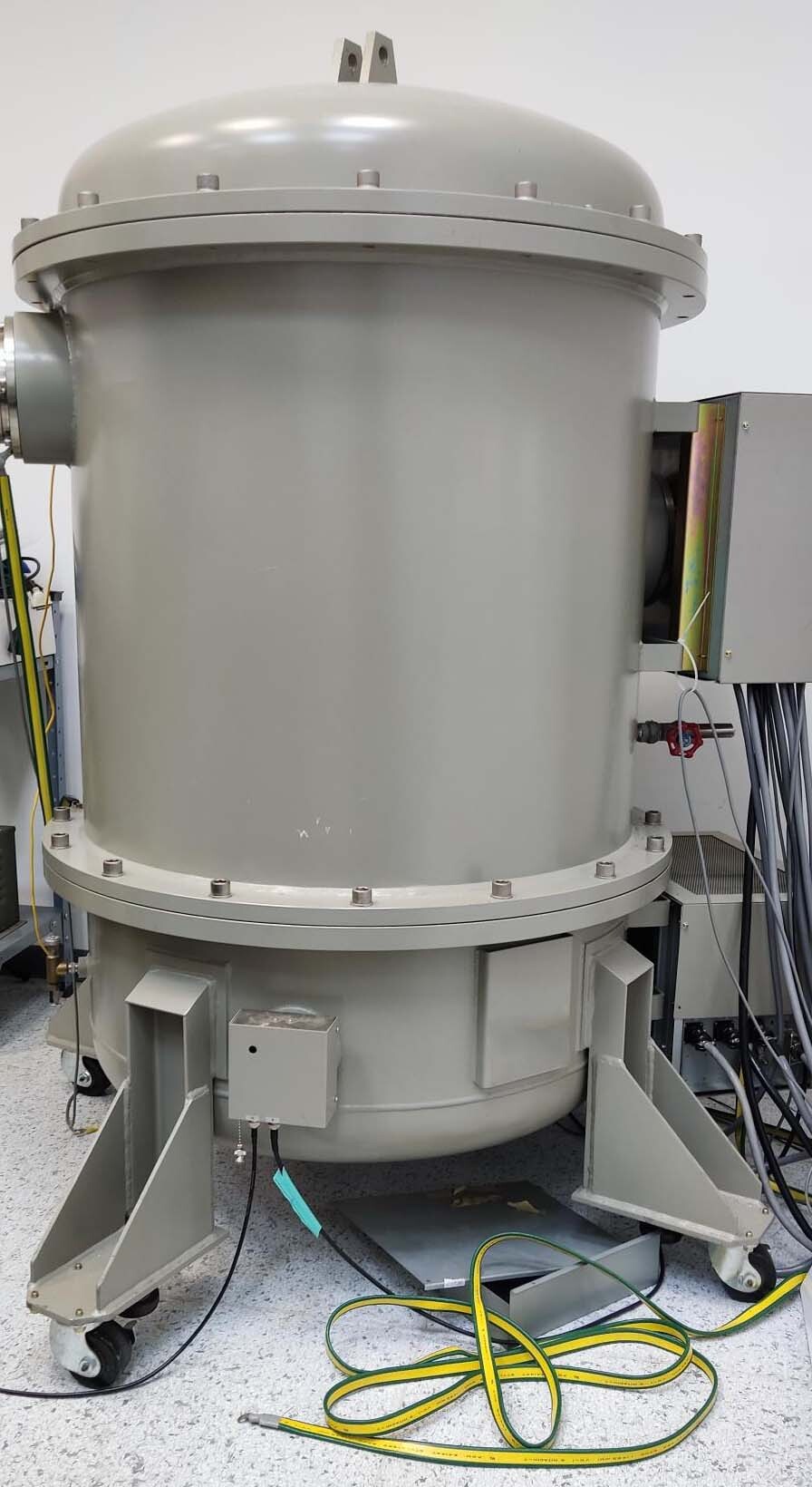









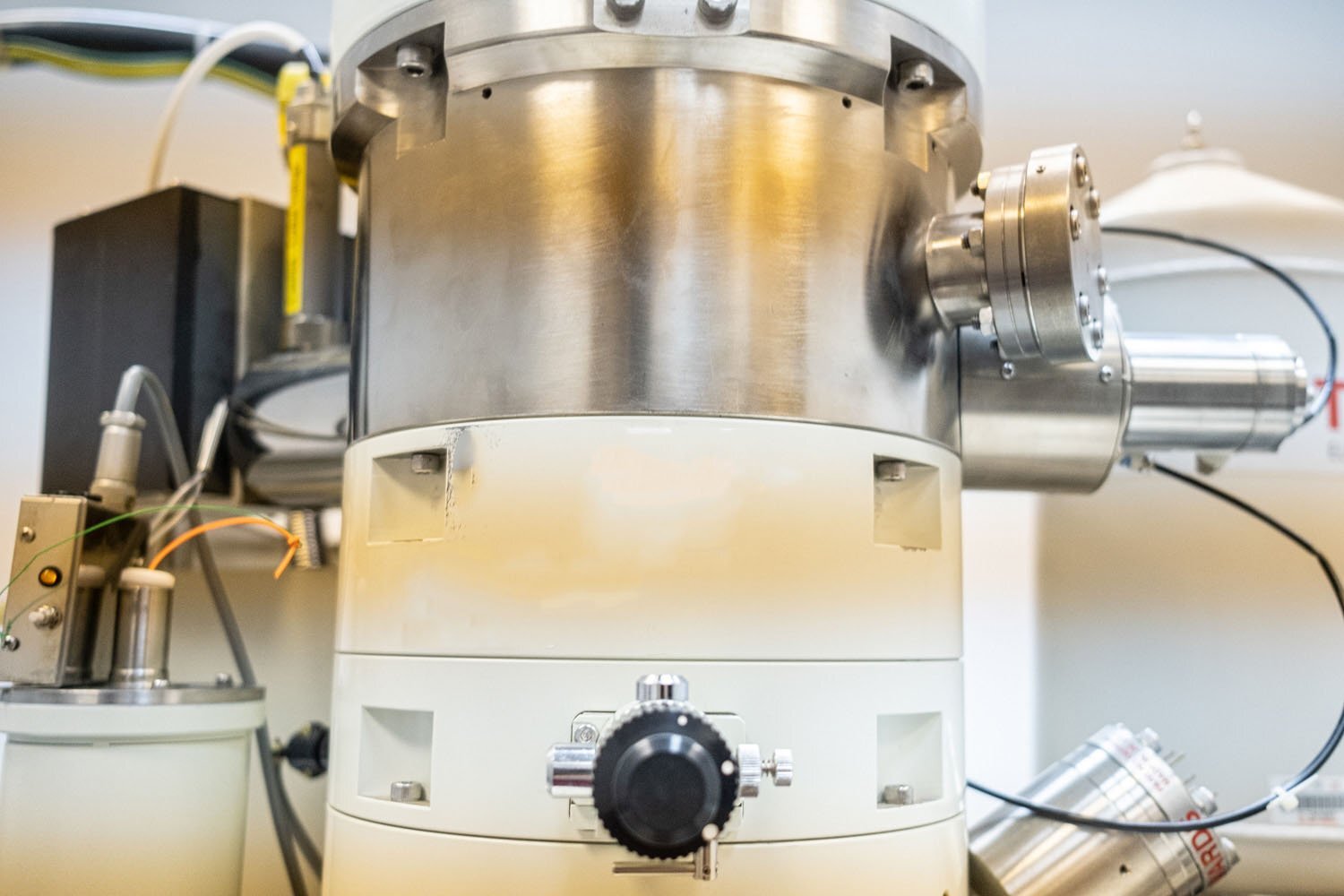































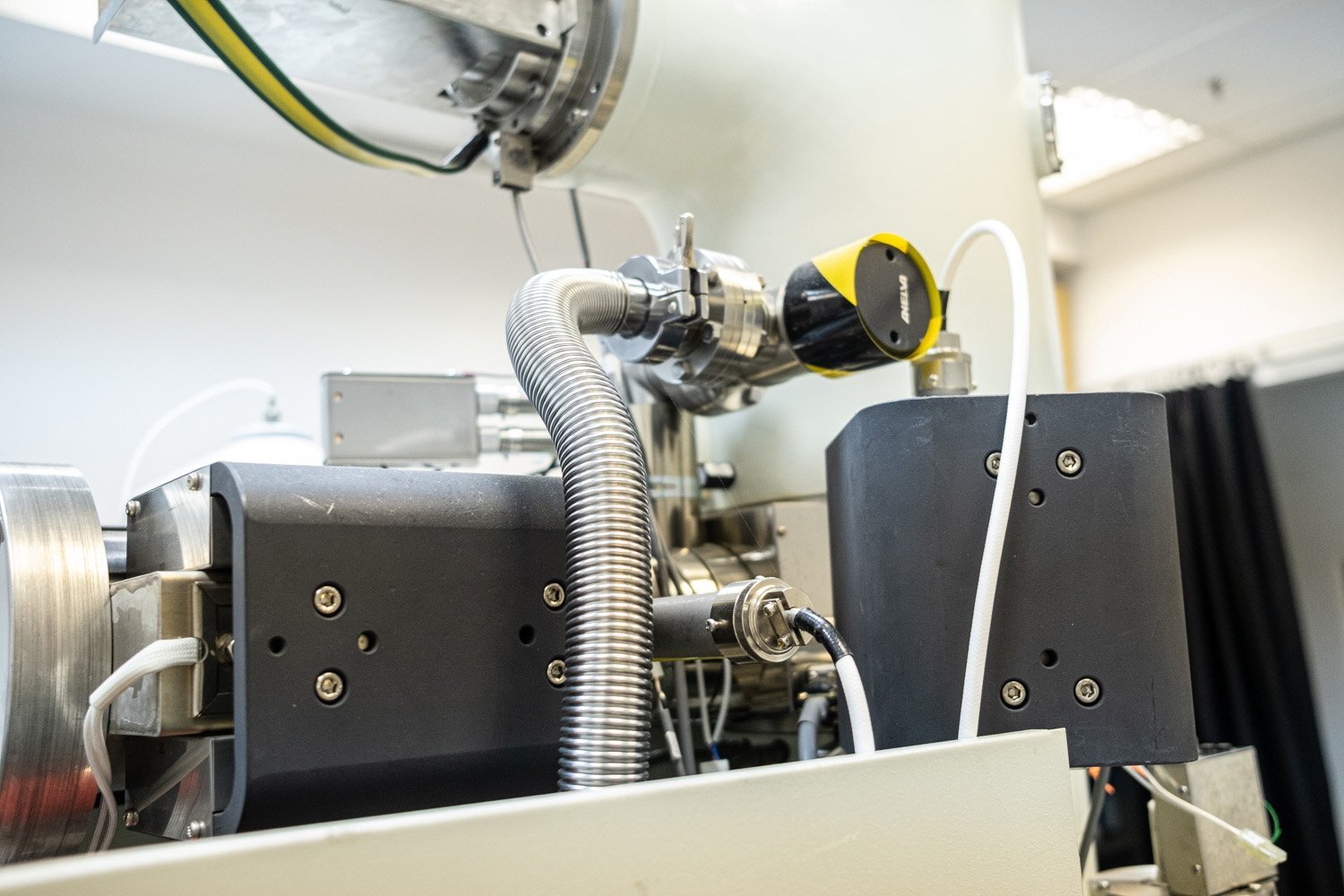





















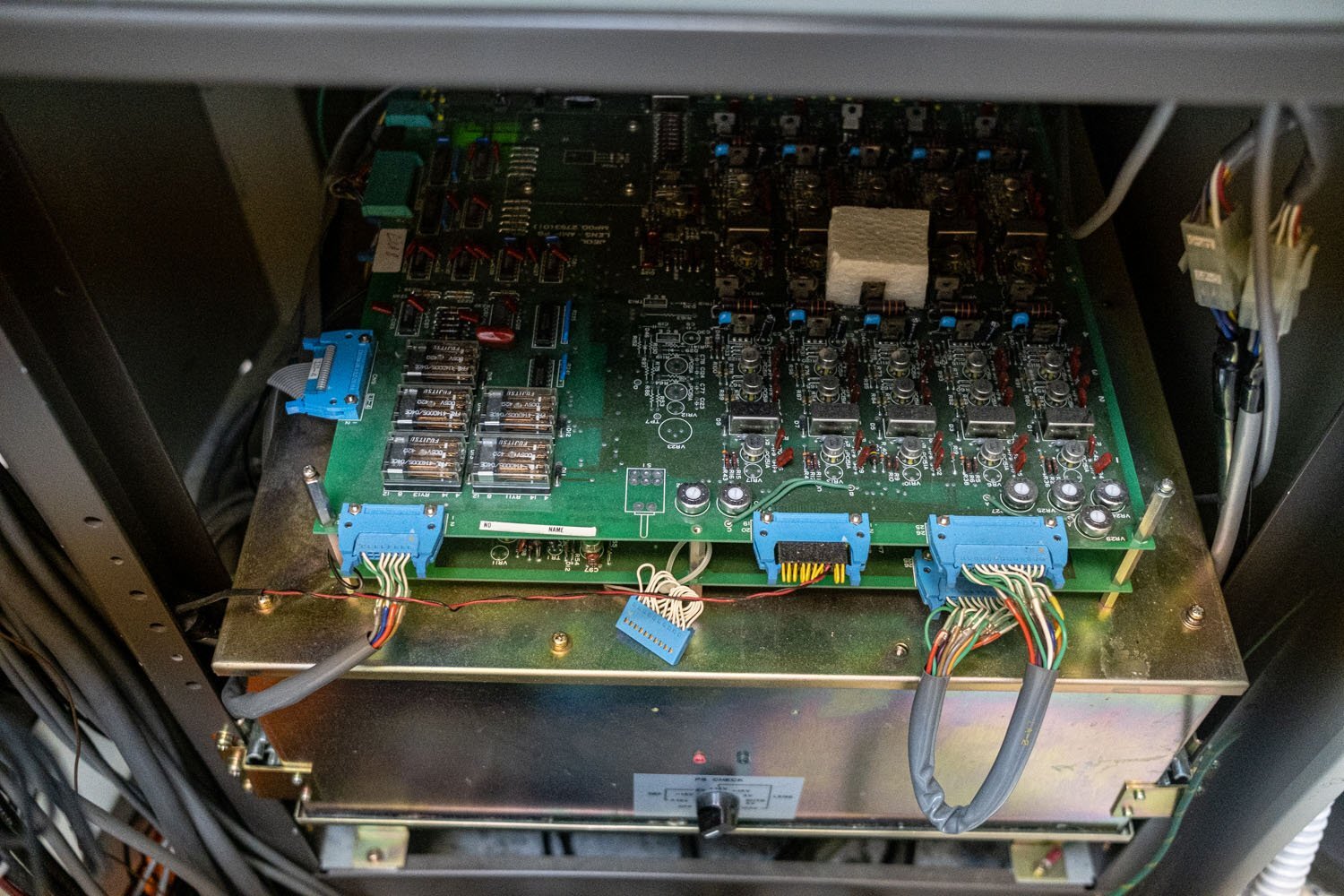

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010F ist ein fortschrittliches Rasterelektronenmikroskop (SEM), das Forschern, Technikern und Branchenexperten die Werkzeuge bietet, die für die Untermikronanalyse erforderlich sind. JEOL JEM-2010F ist für eine Vielzahl von Materialanalysen, Mikroniveaubeobachtungen, Fehleranalysen und automatisierten Betrieb optimiert. JEM 2010F bietet eine sehr hochauflösende Abbildung von kleinen Proben, einschließlich Materialien in trockener und flüssiger Form. Es ist in der Lage, eine Reihe von Probengrößen zu analysieren, von der der 1-Mikron-Öffnungen bis zum 200-Mikron-Bereich. Eine große Schärfentiefe, die von JEM-2010F bereitgestellt wird, ermöglicht die Erfassung detaillierter Bilder bei hohen Vergrößerungen von bis zu 150,000X. Die Kombination aus hoher Auflösung und Tiefenschärfe ermöglicht die Erkennung von oberflächen- und unterflächigen kontrastreichen Merkmalen wie Einschlüssen, Korrosion, Korngrenzen und kristallinen Defekten. JEOL JEM 2010F bietet auch eine Reihe automatisierter Mikroskopiefunktionen, die durch fortschrittliche Softwaretechnologie ermöglicht werden. Die automatisierten Funktionen von JEOL JEM-2010F dem Benutzer viele nützliche Optionen bieten, einschließlich der Kombination von Bilderfassungen aus mehreren Phasen der Analyse, der gleichzeitigen Bearbeitung mehrerer Proben und der Verwendung verschiedener Werkzeuge zur Steuerung des Scanvorgangs. JEM 2010F enthält auch eine Reihe von erweiterten Signalanalyseoptionen für eine Reihe von Proben und Analysetypen. Die in JEM-2010F verfügbaren Signalanalysewerkzeuge können zur Analyse von Signalmustern, chromatischen Veränderungen und Wärmekarten verwendet werden, um Veränderungen in der Materialmikrostruktur bei extrem kleinen Skalen zu erkennen. Die Leistung von JEOL JEM 2010F wird durch seine intelligente Steuerungsausrüstung (ICS) weiter verbessert. Das ICS verfügt über künstliche Intelligenz, um sicherzustellen, dass das System bei jedem Betrieb korrekt funktioniert und die Bildgebung optimiert wird. Die intelligente Einheit ermöglicht auch vollautomatisierte Messszenarien, die dem Anwender eine schnellere Bildgebung, einen höheren Durchsatz und konsistentere Ergebnisse bieten. Abschließend ist JEOL JEM-2010F ein fortschrittliches SEM mit einer Reihe von Funktionen, die eine Echtzeit-Bildgebung mit großen Detaillierungsgraden ermöglichen. Die automatisierten Bildgebungs- und Signalanalysefunktionen bieten eine Reihe leistungsstarker Werkzeuge, um qualitativ hochwertige Ergebnisse zu gewährleisten, während die Intelligent Control-Maschine Zuverlässigkeit und Präzision in jedem Bild bietet.
Es liegen noch keine Bewertungen vor