Gebraucht JEOL JEM 2010F #293595837 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom


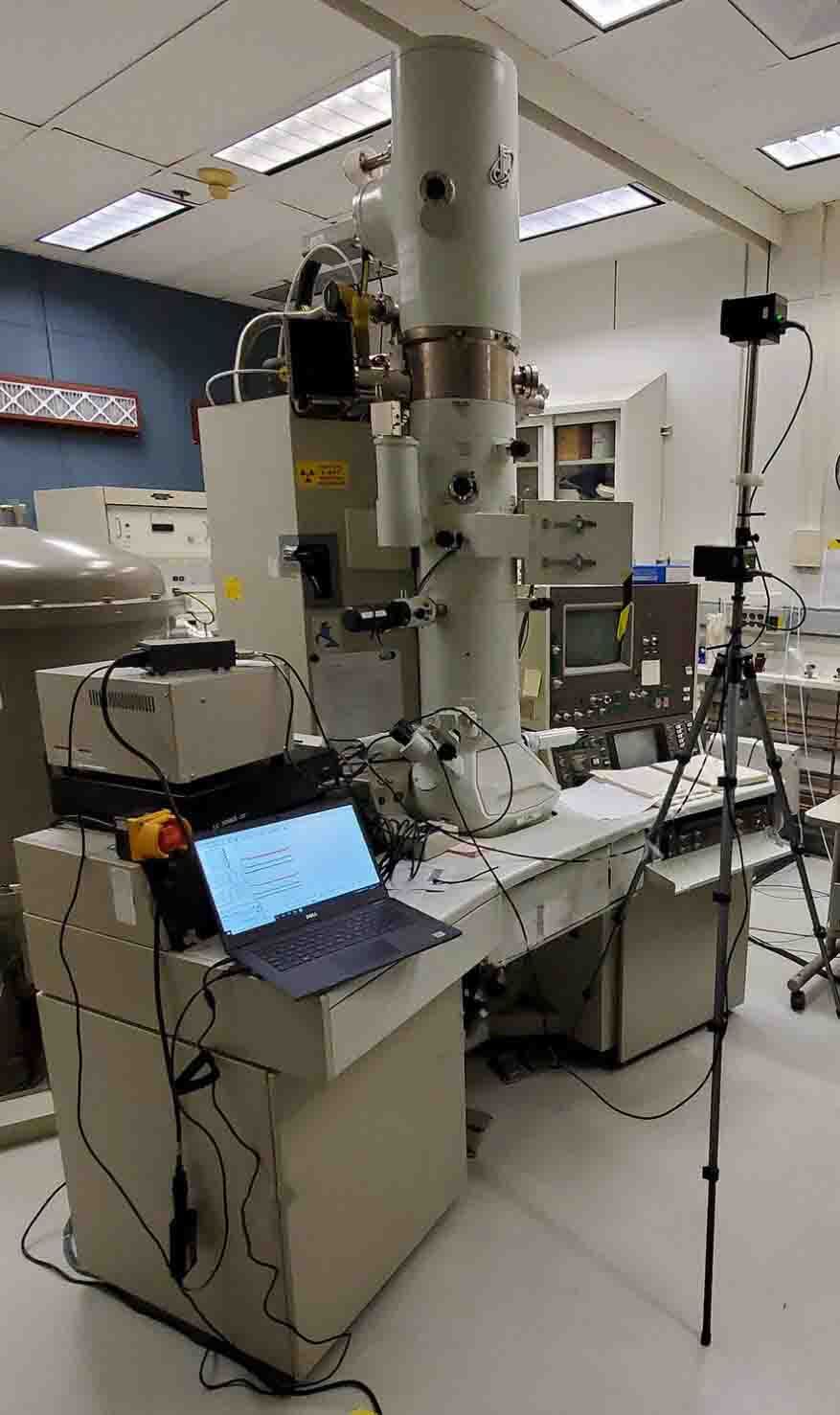

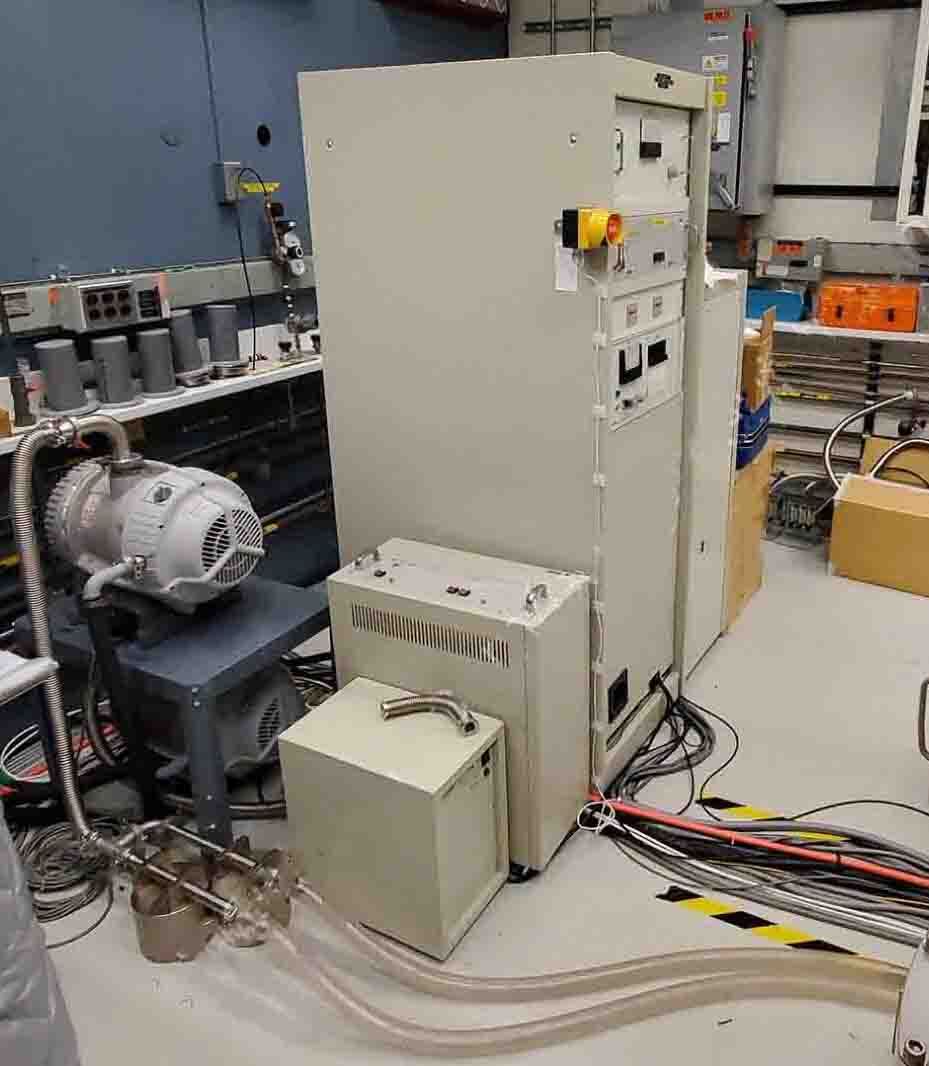





ID: 293595837
Weinlese: 2000
Transmission Electron Microscope (TEM)
Ultra High Resolution (UHR) / High Resolution (HR) / High specimen Tilt (HT) / Cryo Polepice (CR) / High Contrast (HC)
Polepice: URP / HRP / HTP / CRP / HCP
Point: 0.19 nm / 0.23 nm / 0.25 nm / 0.27 nm / 0.31 nm
Lattice: 0.1 nm / 0.1 nm / 0.1 nm / 0.14 nm / 0.14 nm
Focal length: 1.9 mm / 2.3 mm / 2.7 mm / 2.8 mm / 3.9 mm
Spherical coefficient: 0.5 mm / 1.0 mm / 1.4 mm / 2.0 mm / 3.3 mm
Chromatic coefficient: 1.1 mm / 1.4 mm / 1.8 mm / 2.1 mm / 3.0 mm
Focal step: 1.0 nm / 1.4 nm / 1.8 nm / 2.0 nm / 5.2 nm
Solid angle (30 mm²): 0.13 sr / 0.13 sr / 0.13 sr / - / 0.09 sr
Solid angle (50 mm²): 0.24 sr / 0.28 sr / 0.23 sr / - / 0.09 sr
Take-off angle (30 mm²): 25° / 25° / 25° / - / 20°
Take-off angle (50 mm²): 22.3° / 24.1° / 25° / - / 20°
MAG mode: x2,000 to 1,500,000 x 1,500 to 1,200,000 x1,200 to 1,000,000 x1,000 to 800,000
Low MAG: x50 to 6,000 x 50 to 2,000
SA MAG: x8,000 to 800,000 x6,000 to 600,000 x 5,000 to 600,000 x 5,000 to 400,000
SA diffraction: 80 to 2,000 mm, 100 to 2,500 mm, 150 to 3,000 mm
HD: 4 to 80 m
HR: 333 mm
Minimum step size: 50 V
Specimen tilting holder
High tilt specimen retainer
STEM5 Bright-field lattice: 0.2 nm
Electron source:
Schottky emitter: ZrO / W(100)
Brightness: ≧4x10^-8 A / cm² / sr
Pressure: 1x10^-8 Pa
Probe: 0.5 nA for 1 nm
Power Stability:
AC Voltage: ≦1x10^-6 / min
OL Current: ≦1x 10^-6 / min
Modes:
TEM: 2 to 5 nm, 7 to 30 nm
EDS: 4 to 20 nm
NBD: 0.5 to 2.4 nm
CBD: 1.0 to 2.4 nm
Parameters:
Convergence angle: 1.5 to 20 mrad
Acceptance angle: ±10°
Specimen shift:
X, Y-Axis: 2 mm, 2 mm, 2 mm, 2 mm, 2 mm
Z-Axis: ±0.1 mm, ±0.2 mm, ±0.2 mm
Specimen tilt:
X / Y-Axis: ±25 / ±25°, ±35 / ±30°, ±42 / ±30°, ±15 / ±10°, ±38 / ±30°
X-Axis: ±25°, ±80°, ±80°, ±80°, ±80°
Power supply: 160 kV, 200 kV
2000 vintage.
JEOL JEM 2010F ist ein Rasterelektronenmikroskop (SEM) für analytische und materialwissenschaftliche Anwendungen. Es ist mit einer Kaltkathoden (Feldemission) Elektronenquelle ausgestattet, mit ausgezeichneter Quellenstabilität und Helligkeit. Die Quelle erzeugt einen hochauflösenden Elektronenstrahl mit kleinem Durchmesser mit einem Niederspannungsmodus zur Untersuchung empfindlicher Proben. Die Niedrigenergie-Abbildungsstufe ermöglicht die Fähigkeit, Bilder mit hoher Vergrößerung ohne signifikante Aufladung der Probe zu erhalten. Die In-Column-Konfigurationen umfassen eine energiegefilterte Bildgebungsoption, einen koaxialen EDX-Detektor und eine dedizierte Schottky-Pistole. Das Instrument hat auch ein Wolfram-Filament rückgestreut Elektronendetektor, der hohe Vergrößerung und Kontrast Bildgebung bietet. JEOL JEM-2010F Rasterelektronenmikroskop wird von einer integrierten motorisierten x-y-Stufe mit Linearantrieb und einem 10-Positionen-Probenhalter angetrieben. Die integrierte motorisierte x-y-Stufe bietet die hohe Präzisionsbewegung, um die Probe innerhalb des Sichtfeldes des Elektronenmikroskops leicht neu zu positionieren. Es bietet Hochleistungsbildgebung durch automatisches Vorschieben der nächsten Probenposition nach externer Kalibrierungssteuerung. Die Halterung verfügt außerdem über eine Software-Schnittstelle zum automatischen Schreiben von Parameterdaten in Dateien direkt aus dem Elektronenmikroskop. Darüber hinaus verfügt JEM 2010F auch über einen digitalen X-Y-Controller für Live-Imaging-Anwendungen. Der digitale X-Y Controller nutzt die neueste digitale Bildgebungstechnologie und ermöglicht ein integriertes Kamerasystem, das direkt an das digitale Bildgebungsmodul angeschlossen ist. Mit fortschrittlicher digitaler Technologie ist das System in der Lage, hohe Auflösung und schnelle Zykluszeiten bereitzustellen. Schließlich verfügt JEM-2010F über ein umfassendes Bildanalysepaket, das sowohl vollautomatische Funktionen als auch manuelle Einstellungen umfasst. Erweiterte Bildverarbeitungsalgorithmen wie Kantenerkennung, Partikelverfolgung und Formerkennung sind enthalten. Die Schnittstelle ermöglicht auch multimodale Bildgebung sowie eine breite Palette von Analysewerkzeugen, die dem Benutzer eine verbesserte Kontrolle über die Ergebnisse bieten.
Es liegen noch keine Bewertungen vor




