Gebraucht PHILIPS / FEI XL 30 #293619811 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom
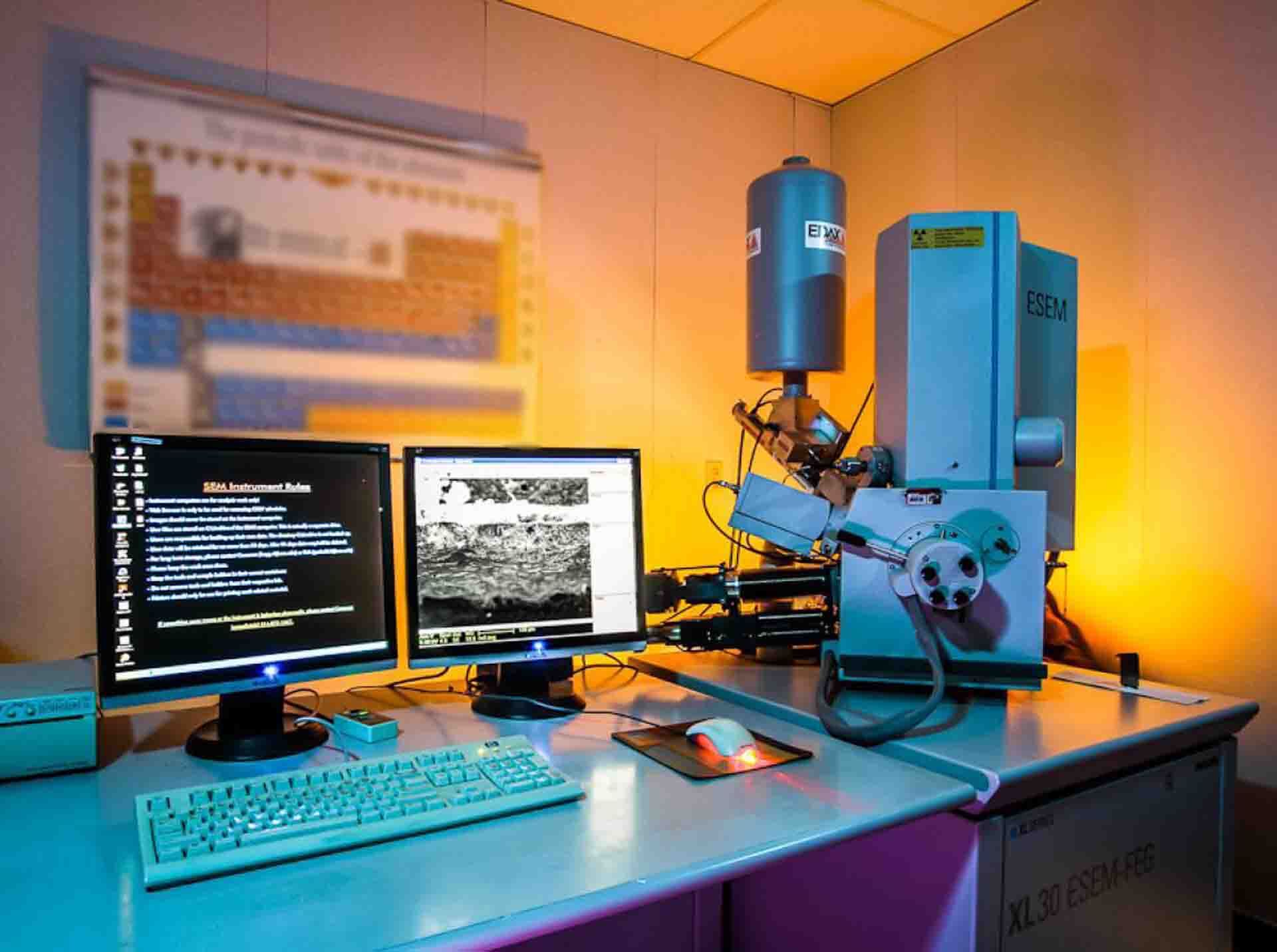

PHILIPS/FEI XL 30 ist ein Rasterelektronenmikroskop (SEM), das für die Bildgebung und Analyse auf Submikronebene entwickelt wurde. Es verfügt über ein energiedispersives Röntgenspektrometriesystem (EDS) und eine Feldemissionskanone mit Aberrationskorrektur. FEI XL 30 bietet drei Abbildungsmodi: sekundäre und rückgestreute Elektronenbildgebung (BSE) oder einen Niederspannungs-Abbildungsmodus, der niedrigere kV für eine verbesserte Leistung bei hohen Vergrößerungen verwendet. PHILIPS XL30 kann Vergrößerungen bis zu 500.000 x mit einer Auflösung von 0,750 nm, einem Druckfenster von 0.35-420PA und einer Kammergröße von 5 x 6 mm erreichen. Das Detektorsystem besteht aus einem bimodalen Detektor, einem Sekundärelektronendetektor und einem energiedispersiven Röntgendetektor (EDX). Der bimodale Detektor umfasst einen gekrümmten nichtreflektierenden Detektor, einen Synchronisationsimpulsdetektor und einen Offenflussfleckdetektor. Der Sekundärelektronendetektor misst die emittierten Elektronen und ist mit einem Ringschlitz ausgestattet, der eine feinere abstimmbare Wegauflösung ermöglicht. Der EDX-Detektor ermöglicht die Elementaranalyse und ist mit einem Streuschutzgitter und einem Aluminium-Röntgenfenster ausgestattet. FEI- XL30 können Proben bei niedrigem und hohem Vakuum analysieren. Zur Einführung der Probe wird eine Probenkammer verwendet und die Umweltbedingungen kontrolliert, um den Einfluss von Feuchtigkeit und Verunreinigungen auf die Probe zu reduzieren. Mit einer Heizstufe kann die Probe auf maximal 3000 ° C erwärmt werden. Die Benutzeroberfläche von PHILIPS/FEI XL30 kann programmiert werden, um alle Mikroskopeinstellungen zu steuern und Standardwerte für alle Einstellungen zu speichern. Der Benutzer kann für jeden Bildgebungsmodus vollständige Profile speichern und abrufen. Der Benutzer hat auch mehrere Optionen zur Steuerung des Betrachtungswinkels, der Vergrößerung und der Balkenform. XL30 bietet eine Reihe von Analysemöglichkeiten, darunter Elektronenmikrographie, Charakterisierung, Oberflächentopographie, Elementaranalyse und Spektroskopie, Fehleranalyse und Tunnelbau. Seine Leistung wird durch die Aberrationskorrektur (CAC) und die kV-Reduktionstechnologie weiter verbessert. Die hohe Stabilität und der geräuscharme Boden des Systems ermöglichen es Benutzern, präzise Messungen vorzunehmen, während seine Genauigkeit und Konsistenz die Reproduzierbarkeit der Ergebnisse ermöglicht.
Es liegen noch keine Bewertungen vor