Gebraucht JEOL JSM 6340F #145143 zu verkaufen
URL erfolgreich kopiert!
Tippen Sie auf Zoom










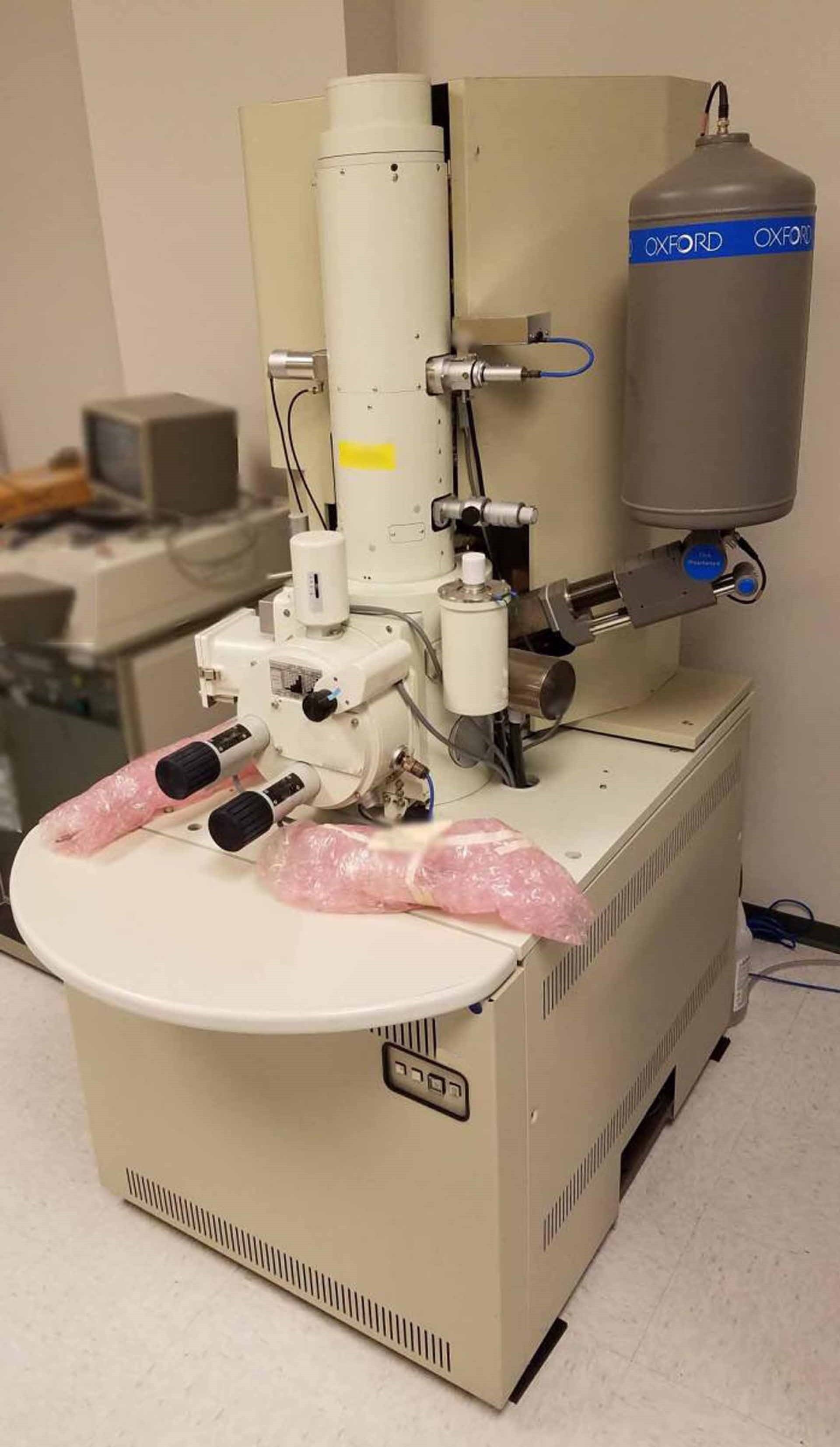



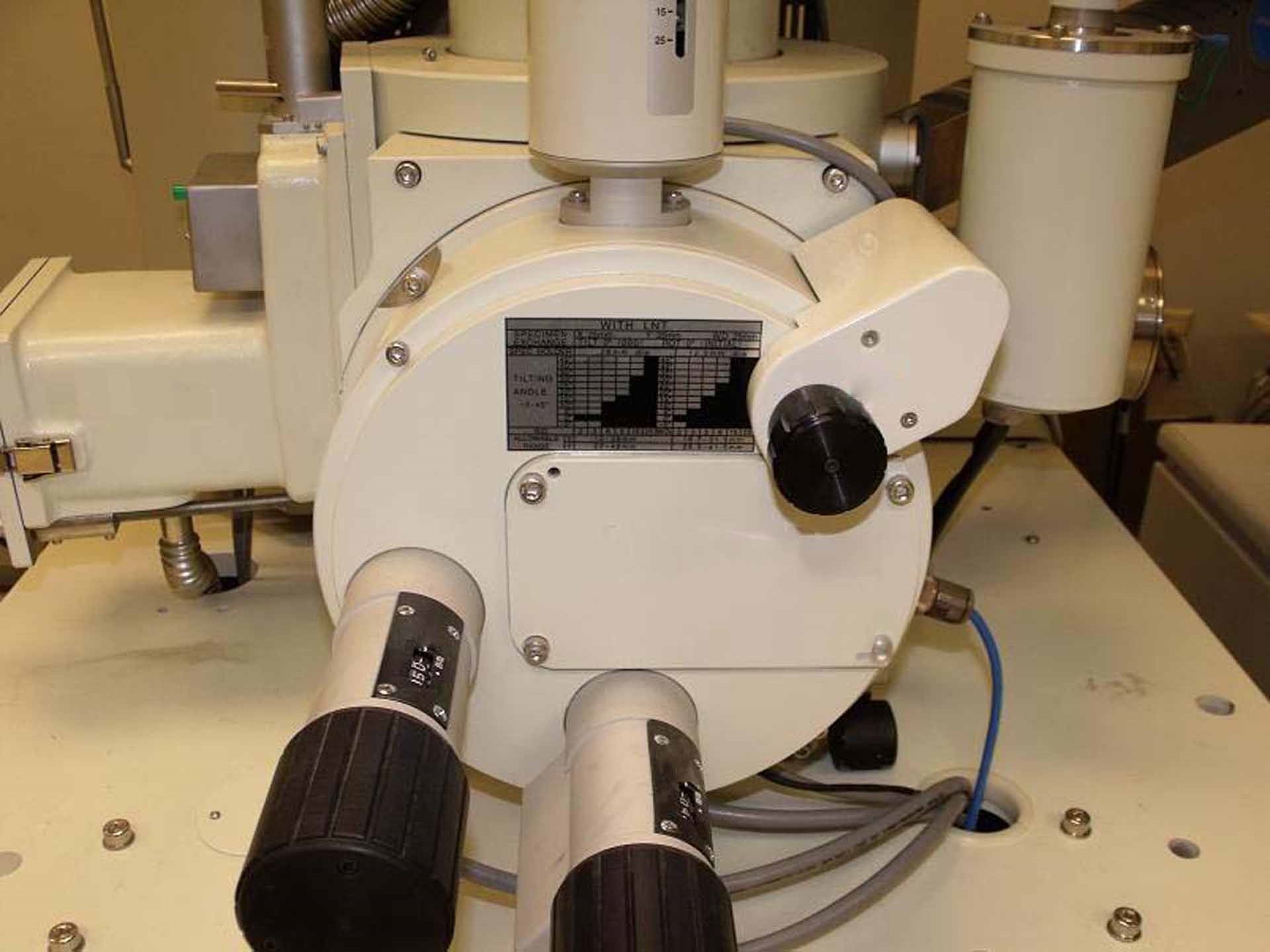

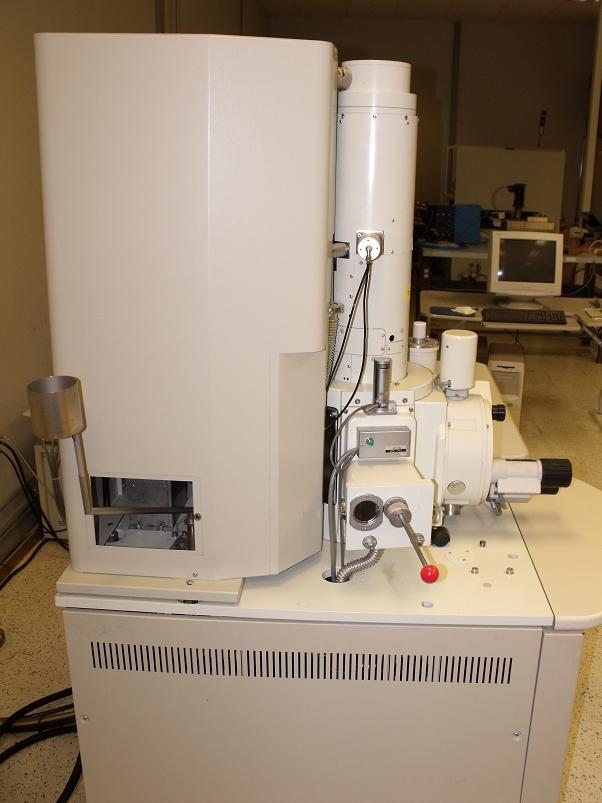















ID: 145143
Wafergröße: 4"
Scanning electron microscope, 4", parts system
Specifications:
In-lens secondary electron detector
Resolution: 2.5nm at 1kV
1.2nm at 20kV
Sample size: 4"
X-Direction: 50 mm
Y-Direction: 70 mm
Chamber:
Airlock, 4"
LN2 cold trap
EDX Capabilities
Chamber camera & monitor
X-Stream imaging system
Operating system: Windows XP
Image capture & networking capability.
JEOL JSM 6340F ist ein Hochleistungs-Rasterelektronenmikroskop (SEM) mit hervorragenden bildgebenden Funktionen. Dieses Gerät ist für eine Vielzahl von Anwendungen in den Bereichen Materialwissenschaft, Halbleiter, Nanotechnologie und Biologieforschung konzipiert. JEOL JSM-6340F verfügt über ein vollautomatisches, kompaktes Säulendesign und ist mit einer Reihe von Detektoren ausgestattet, darunter ein EDX-System (energiedispersives Röntgenspektrometer), ein Rückstreuelektronendetektor (BSE) und ein sekundärelektronendetektor (SE). Dieses SEM ist auch mit einer Top-of-the-Line Niedervakuum (LV) Sekundärelektronen-Abbildungseinheit ausgestattet. Die vollautomatisierte Scan-Steuerung bietet eine schnelle und zuverlässige Datenerfassung, die eine hochauflösende Abbildung einer Vielzahl von Probentypen über eine Vielzahl von Vergrößerungen ermöglicht. Der leistungsstarke SE-Detektor erhöht den Kontrast und die Schärfe der bei hohen Vergrößerungen aufgenommenen Bilder. Eine einzigartige Eigenschaft des JSM 6340 F ist sein ausgezeichnetes niedriges Vakuum sekundäre Elektronbildaufbereitungsmaschine, die Die Technologie einer breiten Reihe der Vergrößerung von 5x bis 300,000x anbietet, Forscher mit einem leistungsstarken Werkzeug versorgend, um Proben an vielfachen Skalen zu analysieren. Das Tool bietet eine Vielzahl von Probenstufen, darunter eine LV-Initialisierungsfunktion mit großem Durchmesser und niedrigem Hintergrund sowie eine automatisierte Übersetzungsstufe. JSM 6340F bietet eine breite Palette von Funktionen, um die Datenerfassung und -analyse einfacher und schneller zu gestalten. Automatische Scan-Geschwindigkeitskontrolle sorgt für genaue Probenvorbereitung und Bildgebung. Der Rückstreuelektronendetektor (BSE) hilft Forschern, die Zusammensetzung und Eigenschaften der Probe zu bestimmen. Das energiedispersive Röntgenspektrometer (EDX) ermöglicht es Benutzern, unbekannte Probenelemente schnell zu analysieren und Elementaranalysen durchzuführen. Darüber hinaus verfügt das Asset über eine Multiscale-Bildgebungssoftware, mit der Benutzer Bilder, die von JEOL JSM 6340 F aufgenommen wurden, mühelos manipulieren können. Diese fortschrittliche Software bietet eine Reihe von Funktionen wie automatische Skalierung, Farbcodierung und Zoomen, wodurch Forscher ihre Daten effektiver analysieren können. Zusammenfassend ist JSM-6340 F-Rasterelektronenmikroskop das ideale Werkzeug für eine breite Palette von Werkstoffwissenschaften, Halbleiter-, Nanotechnologie und biologischen Forschungsanwendungen. Das hochautomatisierte Instrument bietet hervorragende bildgebende Funktionen bei einer Reihe von Vergrößerungen von 5x bis 300000x. Darüber hinaus verfügt das Modell über eine breite Palette von Detektoren, darunter einen Rückstreuelektronendetektor (BSE), ein energiedispersives Röntgenspektrometer (EDX) -Gerät und ein Top-of-the-Line-Niedervakuum (LV) -Sekundärelektronenbildsystem. Um weitere Datenanalysen zu erleichtern, verfügt das Instrument auch über eine fortschrittliche Multiscale-Bildgebungssoftware.
Es liegen noch keine Bewertungen vor















